1、引言
目前CMP技術已在微電子技術多層平整化方面獲得了巨大成功,正向計算機硬盤基片、微機械系統、藍寶石、機械磨具、精密閥門、光學玻璃金屬材料等方面擴展,并從工業加工擴展到軍事應用,如核試驗條件下的精密拋光試驗以及在平面爆轟驅動試驗裝置中的靶板、探針支架、樣品等關鍵零件等,都需要對金屬銅、W-Mo合金Mg-Ag合金、聚碳酸脂等材料實現極高的平坦化加工精度。

因此我們與中國工程物理研究院機械制造工藝研究所合作研制適合W-Mo/Mg-Al 合金化學機械拋光的拋光液項目,提供的片子成分以鉭為主還含有少量鎢、鐵。
金屬鉭Ta 是一種略呈藍色的淺灰色金屬,具有許多奇異特性,有“金屬王國”多面手之譽。鉭質地十分堅硬硬度可達6~6.5,熔點高達2996℃,僅次于鎢和錸位居第三。在制取各種無機酸的設備中,鉭棒可用來替代不銹鋼其壽命比不銹鋼提高幾十倍。在化工、電子、電氣等工業中,鉭常被用來取代鉑,降低費用。鉭具有的特性,使其在電容器
、高溫合金、化工和原子能工業、醫學等領域有十分廣闊的應用前景。但鉭質地很硬,提高它的CMP 速率很不容易,因此我們嘗試了一種新型的拋光液,在保證其拋光表面質量的前提下提高其拋光速率。
2、實驗研究
2.1 實驗設備和材料
實驗設備電熱鼓風干燥箱,C6382I W/YJ型拋光機,JJ2000 型電子天平。
檢測設備:紅外線測溫儀、千分表。
實驗材料:硅溶膠(自制)、去離子水(自制),制電導率>5Ω活性劑(自制),由中國工程物理研究院機械制造工藝研究所提供的φ50mm鉭片,鉭含量較高含有少量的鎢和鐵。
2.2 實驗步驟
1)將陶瓷托盤放入恒溫箱從室溫升高到一定溫度,恒溫一段時間后,取出,然后將拋光蠟均勻涂抹在粘片處,把片子輕輕放在涂蠟處,緩緩輕揉,最后取另一平滑的托盤輕放其上,待冷卻到室溫后,用脫脂棉蘸酒精將片子表面及其周邊處理干凈;
2)將測量點定位,并用千分表測量拋光前厚度的初始值;
3)使用配制的拋光液在拋光機上拋光鉭片,并記錄試驗現象;
4)拋光結束后,觀察拋光片的表面狀態,測量拋光后鉭片的厚度;
5)清洗拋光片及拋光機的漿料通道和拋光布。
2.3 實驗結果與討論
采用河北工業大學自制硅溶膠,向其中加入一定量的有機堿,攪拌均勻;再向其中加入適量螯合劑,FA/O 活性劑及氧化劑,攪拌均勻在C6382I W/YJ 型拋光機上對鉭片拋光,實驗條件為溫度25℃,漿料的流速250ml/min;拋光時間15min,水拋1min 拋光后得到拋光壓力與拋光速率的關系曲線如圖1 所示。

從圖中可看出,隨拋光壓力的增大,拋光速率加快,而且,總體來看,拋光速率均較大,并且其表面光亮、平整,表面粗糙度為0.1409~0.1429nm符合拋光要求。
3、鉭拋光機理
CMP 利用機械力量對拋光片表面做功,提供表面薄膜層斷裂腐蝕或生長的力量,并使用漿料中的化學物質來提高拋光效率。
目前CMP機理模型大多采用Preston方程R=Kppv( R為拋光速率;p為壓力;v 為拋光墊與晶片的相對轉速),主要考慮壓力、轉速等機械作用對拋光速率的影響。Preston模型只從機械作用的角度定性給出去除速率與壓力和轉速的關系而沒有考慮化學作用,而化學作用應更復雜重要。展現化學作用速率的是Arrhenius方程,v=Kexp(-Ea/Rt) ,但它忽視了機械作用的影響。經大量實驗后發現,CMP過程中速率不是機械與化學作用的簡單相加,而是v總>>v機+v化。CMP是在一定壓力下,在旋轉有磨料狀態下的多相化學機械的復雜過程,按現有的Preston方程和Arrhenius 方程均無法全面解釋CMP過程中的現象。試驗表明,CMP是一個多相作用過程。是機械作用與化學作用互相加強與促進的過程。當鉭與拋光液接觸時,表面發生鈍化發生反應
2Ta+5H2O Ta2O5+10H++10e- (1)
然后鉭表面的Ta-0-H 與硅溶膠中的Si-0H團形成化學鏈,發生反應
Ta-0-H+Si-0-H Ta0-Si+H20
其拋光機理如圖2 所示。
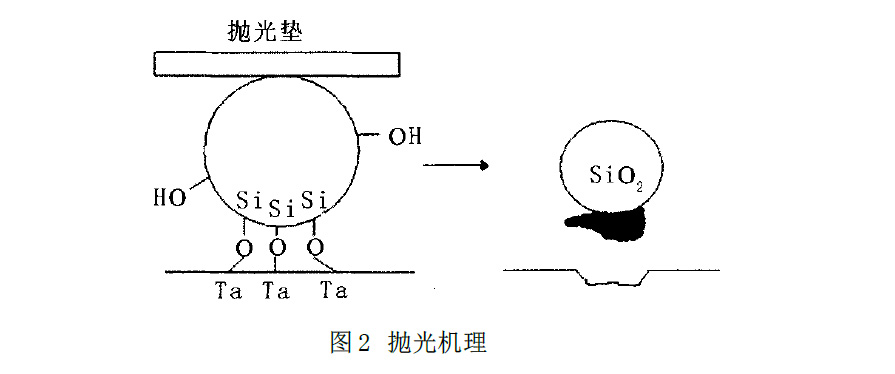
首先硅溶膠粒子和Ta2O5 表面發生鍵合, 然后,周圍硅溶膠粒子的運動產生的應力使二氧化硅粒子和Ta2O5 在研磨粒子及拋光布的磨擦攜帶下從Ta 表面剝離,脫離表面,使新裸露的表面再繼續反應,循環往復。由于磨料硅溶膠粒子與Ta表面的鍵合作用強烈,因此拋光速率較高。
4、結語
隨著微電子技術的發展,CMP技術不斷拓展,應用范圍也不斷擴大。現將該技術應用于工程物理研究院工程物理仿真實驗用以Ta為主要元素的材料表面加工過程中時,因其一直以機械加工為主要加工手段,精度較低,表面粗糙度只能達到微米級。而目前急于提高加工的精密度,使粗糙度能達到納米級,故我們采用的技術路線是增加化學作用,利用化學機械全局平整化的方法進行加工,根據CMP理論及相關技術獲得突破達到良好的拋光效果。
相關鏈接